メーカー情報
大日本印刷・次世代半導体パッケージ向け“TGVガラスコア基板”を開発
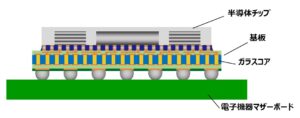
大日本印刷株式会社(以下:DNP)はこのほど、次世代半導体パッケージに向けた“TGV(Through Glass Via : ガラス貫通電極)ガラスコア基板”を開発。FC-BGA(Flip Chip-Ball Grid Array)など従来の樹脂基板をガラス基板に置き換える製品であり、高密度なTGVによって従来技術よりも高性能な半導体パッケージの提供を可能とした。また、パネルの製造プロセスを適応することにより高効率・大面積化にも対応する。
デジタルトランスフォーメーション(DX)の進展に伴い飛躍的にデータ流通量が増大し、社会インフラを支える半導体のさらなる性能向上と高い信頼性が求められている。
そのため、機能の異なる複数の半導体チップをひとつの基板上に高密度で実装し、処理速度を向上させる次世代半導体パッケージが注目されている。
しかし、GIP (Glass Interposer)などパッケージの中継基板「インターポーザ」*1の電極形成技術において、極めて狭く配線するファインピッチ化や、パッケージの大面積化などが難しいという課題があった。
こうした課題に対してDNPは今回、半導体パッケージの基材としてガラスに着目し、ファインピッチに対応した高アスペクト比(ガラスの厚みを貫通孔径で割った比率)の微細な貫通電極を形成したガラスコア基板を開発した。
今後の展開として、DNPは、すでに開発済みのガラス貫通孔に銅を充填する「充填タイプ」に加えて、今回開発した「コンフォーマルタイプ」のガラスコア基板についてもパネルサイズ510×515mmへのスケールアップを進め、2027年度に50億円の売り上げを目指す。


